Dynamische HTGB / DGS Testsysteme
Gate-Stresstest für SiC- und
GaN-Halbleiter
Wide-Bandgap-Halbleiter aus Siliziumcarbid (SiC) und Galliumnitrid (GaN) verlangen nach neuen Testmethoden. Das dynamische HTGB / DGS Testsystem deckt die Anforderungen von verschiedener Seite ab und ermöglicht gleichzeitiges Testen von bis zu 3 Losen mit 80 Prüflingen.
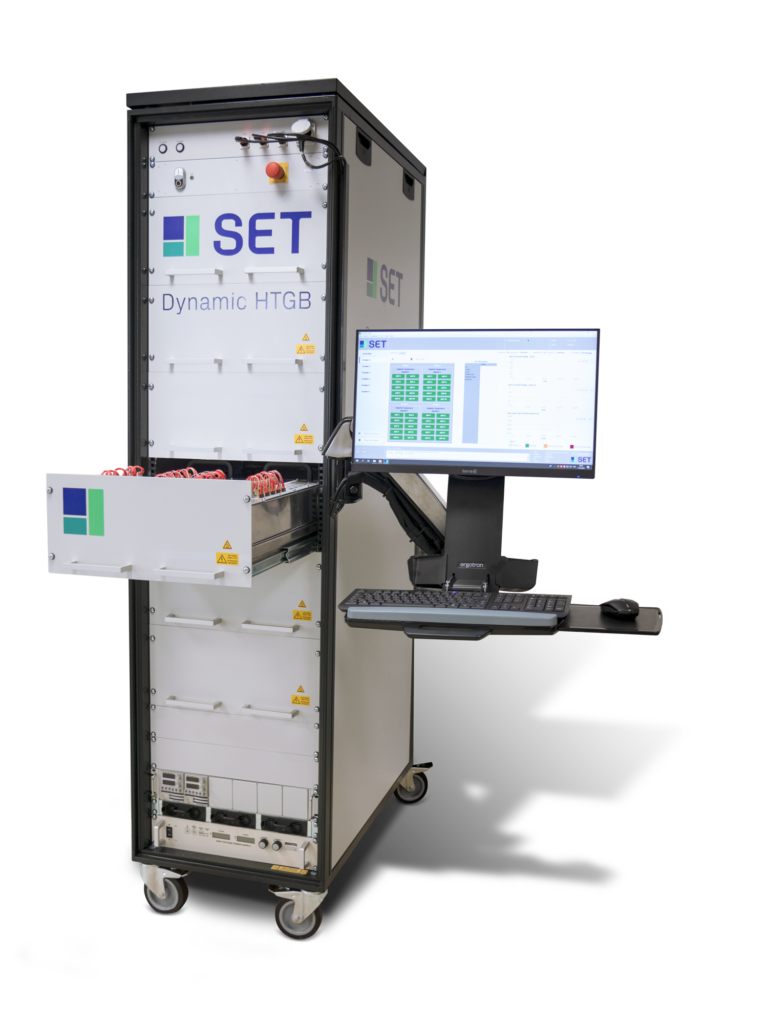
Maßgeschneiderte Testsysteme für neue Wide-Bandgap-Materialien
Um die Anforderungen anspruchsvoller Zukunftstechnologien zu erfüllen, kommt es in der Leistungselektronik mehr denn je auf umweltschonende Energieeffizienz an. Deshalb sind Wide-Bandgap-Materialien wie Siliziumcarbid oder Galliumnitrid geeignete Kandidaten, um das klassische Silizium in der Produktion von Leistungshalbleitern zu ersetzen.
Anspruchsvolle Einsatzbereiche in der Leistungselektronik wie E-Mobilität oder regenerative Energiegewinnung geben die Bedingungen vor, unter denen sich Wide-Bandgap-Bausteine bewähren müssen. Materialspezifische Zuverlässigkeitstests sind zwar noch nicht normiert, müssen aber präzise auf die Anforderungen der Industrie zugeschnitten sein. SET begegnet dieser Herausforderung mit eigens entwickelten Lösungen, zu denen auch die dynamischen Testsysteme aus dem Bereich HTGB (High Temperature Gate Bias) / DGS (Dynamic Gate Stress) gehören.
Download Flyer
Verfügbar in:
- ENGLISCH
High Temperature Gate Bias / Dynamic Gate Stress
High Temperature Gate Bias (HTGB) oder auch HTGS (High Temperature Gate Stress) und DGB (Dynamic Gate Bias) ist ein Test, welcher durch schnelle Spannungsänderungen am Gate gezielt Fehlermechanismen stimuliert. Der Test stellt keine Beschleunigung eines statischen HTGB dar und dient auch nicht zur Prüfung der Isolationsfähigkeit. Das Testsystem deckt alle relevanten Prüfvorschriften ab und führt vollautomatische Tests mit umfangreichem Reporting durch.
Das dynamische HTGB Testsystem bietet neben den Stimuli umfangreiche in-situ Messungen, welche alle 5 Minuten relevante Parameter bestimmen. Dadurch wird neben dem Gesamteinfluss auch die zeitliche Verteilung sichtbar was konkrete Aussagen für die Prüflinge im Feld erlaubt.

Technische Daten
| Test system type | Dynamic HTGB / DGS test system |
| Dynamic HTGB stimuli |
|
| HTGB measurement |
|
ANFRAGE
Testing as a Service
Sie möchten Ihre Prüflinge extern bei einem Spezialisten testen lassen? Mit unserem Inhouse-Service „Testing as a Service“ bieten wir ihnen einfaches und schnelles Testen direkt beim Experten vor Ort an.
Kompetent und engagiert: Testentwicklung bei SET
Die Erwartungen an Wide-Bandgap-Halbleiter sind hoch. Demgegenüber fehlt es in vielen Fällen noch an der Spezifikation verbindlicher Testszenarien für die Prüfung ihrer Leistungszuverlässigkeit. In dieser anspruchsvollen Situation greift SET auf umfangreiches Wissen und langjährige Erfahrung zurück, um perfekt auf die Materialeigenschaften und die Anforderungen der Industrie zugeschnittene Testsysteme zu entwickeln.
SET ist Mitglied der ECPE und engagiert sich in der Arbeitsgruppe AQG 324 für die Definition verbindlicher Qualifizierungsrichtlinien. Wenn wir an innovativen Lösungen für den Test von SiC- und GaN-Halbleitern arbeiten, haben wir die Anforderungen von Herstellern, Re-Sellern und Kunden stets im Blick. Dabei kooperieren wir mit Hochschulen und Forschungsabteilungen, um aktuelle und zukünftige Technologien durch normierte Zuverlässigkeitstest abzusichern. Zudem richtet die SET seit Jahren den International Power Semiconductor Reliability Round Table für die Leistungshalbleiter-Branche aus.
SUPPORT
Sie haben Fragen zu den Halbleiter-Testsystemen oder möchten ein Angebot?
Wir freuen uns auf Ihre Anfrage. Unser Support-Team steht Ihnen jederzeit für Fragen zur Verfügung. Gerne erstellen wir Ihnen ein maßgeschneidertes Angebot nach Ihren Anforderungen.


